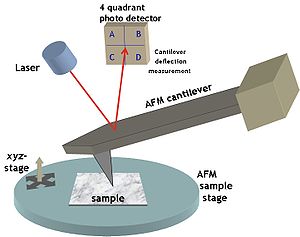
Atomivoimamikroskoopit (AFM) ovat eräänlainen mikroskooppi, jolla voidaan kuvata ja mitata materiaalien pintoja atomisella tai lähellä atomista tasoa olevalla tarkkuudella. AFM-mittalaitteilla saadaan kuva pintarakenteista, pinnan topografiasta ja paikallisista voimavaikutuksista — jopa yksittäisten atomien tasolla tietyissä olosuhteissa. AFM:ää käytetään laajalti materiaali- ja pintatutkimuksessa sekä nanoteknologiassa, ja sen sovelluksiin kuuluvat myös biologisten näytteiden, puolijohteiden ja pinnoitusprosessien tutkimus.
Miten AFM toimii
AFM perustuu erittäin ohueen kärkineulaan (tip), joka on kiinnitetty taipuvaan konsolipalkkiin (cantilever). Kärkeä liikutetaan näytteen pinnan yli ja se "tunnustelee" pinnan harjanteita ja laaksoja. Kun kärki nousee ja laskee pinnan mukaan, konsoli taipuu tai värähtelee. Konsolin taipuman tai värähtelyn muutokset mitataan tyypillisesti lasersäteellä, joka heijastuu konsolin pinnalta fotodiodille tai muulle detektorille; näin saadaan tarkkaa tietoa pinnan korkeuseroista ja voimasuhteista.
Näytettä liikutetaan suhteessa kärkeen usein piezoelektrisellä skannerilla, joka pystyy liikuttamaan näytettä (tai kärkeä) nanometriluokan askelissa x-, y- ja z-suunnissa. AFM-järjestelmän keskeisiä osia ovat siis kärki, konsoli, lasersäteen detektori, piezoskanneri ja palautesilmukka (feedback loop), joka ylläpitää halutun etäisyyden tai voiman kärkien ja näytteen välillä.
Toimintatilat
AFM:llä on useita toimintatiloja, joista yleisimmät ovat:
- Kontaktitila: kärki pysyvästi kosketuksissa näytteen kanssa ja konsolin taipumaa mitataan suoraan. Tämä tila sopii jäykille näytteille, mutta voi vahingoittaa pehmeitä pintoja ja kuluttaa kärkeä.
- Napauttamistila (tapping mode): kärki värähtelee resonanssitaajuudella ja napauttaa pintaa kevyesti kontaktin sijaan. Tämä vähentää sivuttaisvoimia ja on usein parempi biologisille tai pehmeille näytteille.
- Ei-kosketustila: kärki värähtelee hieman kauempana pinnasta ja huomaa vaihtelut van der Waalsin voimissa tai muissa vuorovaikutuksissa. Tämä tila vaatii usein hyvän vakiotilan ja puhtaan ympäristön (esim. tyhjiö).
- Dynaamiset ja staattiset tilat: viittaavat siihen, käytetäänkö konsolin dynaamista värähtelyä vai mitataanko staattista taipumaa. Monet nimitykset kuten "ajoittainen kosketustila" ovat variaatioita edellä mainituista periaatteista.
Mittaustiedot ja rajoitukset
AFM pystyy antamaan erittäin korkean vertikaalisen resoluution, usein sub-nanometriluokan ja käytännössä jopa atomisen korkeustarkkuuden suotuisissa olosuhteissa. Lateralinen (poikittainen) resoluutio riippuu kärjen kärjen säteestä ja muiden olosuhteiden vaikutuksesta; ideaalitilanteessa voidaan havaita yksittäisiä atomeja, mutta usein lateraalinen resoluutio on nanometriluokkaa.
Rajoituksia ja huomioitavia seikkoja:
- Vino kuva (tip convolution): kärjen muoto vaikuttaa mitattuun topografiaan, mikä voi vääristää kapeiden tai jyrkkäreunaisten kohteiden mittauksia.
- Kärjen kuluminen ja vaurioituminen: aktiivinen kuvaus tai kova kontakti voi kuluttaa kärkeä, mikä heikentää resoluutiota.
- Näytteen vaurioituminen: erityisesti kontaktitilassa pehmeät näytteet voivat vahingoittua.
- Nopeus: AFM-kuvantaminen on yleensä hitaampaa kuin optiset menetelmät, sillä pinta skannataan pistemäisesti.
Sovellukset ja lisätoiminnot
AFM ei ole pelkästään topografian mittauslaite — sillä voidaan myös mitata paikallisia fysikaalisia ominaisuuksia:
- Voimaspektroskopia (force–distance curves): mittaa kärkien ja näytteen välisiä voimia, adhesiota, jäykkyyttä ja elastisia ominaisuuksia.
- Sähköiset mittaukset (conductive AFM): mitataan paikallista johtavuutta tai potentiaalia.
- Magnetiset mittaukset (MFM): kartoitus magneettisista voimista pinnalla.
- Nanomanipulaatio: kärkeä voidaan käyttää siirtämään partikkeleita tai järjestämään atomeja erittäin kontrolloidusti.
Käytännön huomioita näytteen käsittelystä
- AFM voi toimia ilmassa, tyhjiössä tai nesteessä. Nesteolosuhteet ovat tärkeitä elävien biologisten näytteiden tutkimuksessa.
- Näytteet kannattaa kiinnittää tukevasti ja niiden pinnan tulee olla sopivan tasainen ja puhdas tavoitellun mittauksen onnistumiseksi.
- Konsolin ja kärjen valinta (jousivakio, kärjen säde, materiaalit) vaikuttaa sekä herkkyyteen että mittauksen luotettavuuteen.
Yhteenvetona AFM on monipuolinen ja herkkä työkalu pintatutkimukseen, joka täydentää muita mikroskopiatekniikoita kuten pyyhkäisyelektronimikroskooppia (SEM). AFM:n etuina ovat korkea vertikaalinen resoluutio ja kyky mitata pintoja myös nesteessä, mutta käytännössä mittaustulos riippuu laitteiston asetuksista, kärjestä ja näytettä koskevista rajoituksista.